
- 原子层沉积2024-09-26 18:52:58
- 原子层沉积是一种用于制造超薄膜的技术,通过逐层沉积材料原子来控制膜的厚度和均匀性。
资源:85个 浏览:2次
原子层沉积相关内容
-
- 第一届亚太原子层沉积会议
- 第一届亚太原子层沉积会议\x0d\x0a1st Asian-Pacific Atomic Layer Deposition\x0d\x0a(AP-ALD) Conference\x0d\x0aOct 18-20,2024
-
- 【飞纳三点半】第 69 期直播通知:走进苏州体验中心,实地体验粉末原子层沉积技术
- 让科学走进生活,认识微观世界变得如此简单!周三下午三点半,飞纳电镜视频号直播间,与您不见不散!
产品名称
所在地
价格
供应商
咨询

- 粉末原子层沉积系统ALD
- 国外 美洲
- 面议
-
深圳市科时达电子科技有限公司
售全国
- 我要询价 联系方式

- 原子层沉积系统ALD
- 国外 欧洲
- 面议
-
爱谱斯中国有限公司
售全国
- 我要询价 联系方式

- 大尺寸原子层沉积系统
- 国内 广东
- 面议
-
北京正通远恒科技有限公司
售全国
- 我要询价 联系方式

- ald原子层沉积 NLD-3000原子层沉积系统 那诺-马斯特
- 国外 美洲
- 面议
-
那诺—马斯特中国有限公司
售全国
- 我要询价 联系方式
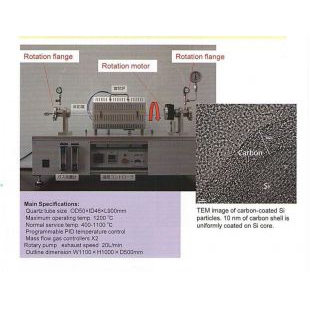
- 原子层沉积系统
- 国外 亚洲
- 面议
-
深圳市科时达电子科技有限公司
售全国
- 我要询价 联系方式
- 2022-10-24 16:06:14一文读懂ALD原子层沉积技术
概述:
原子层沉积(Atomic layer deposition)是一种可以将物质以单原子膜形式一层一层的镀在基底表面的方法。原子层沉积与普通的化学沉积有相似之处。但在原子层沉积过程中,新一层原子膜的化学反应是直接与之前一层相关联的,这种方式使每次反应只沉积一层原子。
单原子层沉积(atomic layer deposition,ALD),又称原子层沉积或原子层外延(atomic layer epitaxy) ,是一种基于有序、表面自饱和反应的化学气相薄膜沉积技术。最初是由芬兰科学家提出并用于多晶荧光材料ZnS:Mn以及非晶Al2O3绝缘膜的研制,这些材料是用于平板显示器。由于这一工艺涉及复杂的表面化学过程和低的沉积速度,直至上世纪80年代中后期该技术并没有取得实质性的突破。
但是到了20世纪90年代中期,人们对这一技术的兴趣在不断加强,这主要是由于微电子和深亚微米芯片技术的发展要求器件和材料的尺寸不断降低,而器件中的高宽比不断增加,这样所使用材料的厚度降低至几个纳米数量级。
因此,原子层沉积技术的优势就体现出来,如单原子层逐次沉积,沉积层极均匀的厚度和优异的一致性等就体现出来,而沉积速度慢的问题就不重要了。以下主要讨论原子层沉积原理和化学,原子层沉积与其他相关技术的比较,原子层沉积设备,原子层沉积的应用和原子层沉积技术的发展。
原子层沉积系统(ALD)的原理:
原子层沉积是通过将气相前驱体脉冲交替地通入反应器并在沉积基体上化学吸附并反应而形成沉积膜的一种方法(技术)。当前驱体达到沉积基体表面,它们会在其表面化学吸附并发生表面反应。在前驱体脉冲之间需要用惰性气体对原子层沉积反应器进行清洗。由此可知沉积反应前驱体物质能否在被沉积材料表面化学吸附是实现原子层沉积的关键。气相物质在基体材料的表面吸附特征可以看出,任何气相物质在材料表面都可以进行物理吸附,但是要实现在材料表面的化学吸附必须具有一定的活化能,因此能否实现原子层沉积,选择合适的反应前驱体物质是很重要的。
图1
基于原子层沉积的原理,利用原子层沉积制备高质量薄膜材料,三大要素必不可少:1)前驱体需满足良好的挥发性、足够的反应活性以及一定热稳定性,前驱体不能对薄膜或衬底具有腐蚀或溶解作用(图2 A);2)前驱体脉冲时间需保证单层饱和吸附(图2 A);3)沉积温度应保持在ALD窗口内,以避免因前驱体冷凝或热分解等引发CVD生长从而使得薄膜不均匀(图2 B)。
图2
原子层沉积的表面反应具有自限制性(self-limiting),实际上这种自限制性特征正是原子层沉积技术的基础。不断重复这种自限制反应就形成所需要的薄膜。
原子层沉积的自限制特征 :根据沉积前驱体和基体材料的不同,原子层沉积有两种不同的自限制机制,即化学吸附自限制(CS)和顺次反应自限制(RS)过程。
化学吸附自限制沉积过程中,第一种反应前驱体输入到基体材料表面并通过化学吸附(饱和吸附)保持在表面。当第二种前驱体通入反应器,起就会与已吸附于基体材料表面的第一前驱体发生反应。两个前驱体之间会发生置换反应并产生相应的副产物,直到表面的第一前驱体完全消耗,反应会自动停止并形成需要的原子层。因此这是一种自限制过程,而且不断重复这种反应形成薄膜。
图3
与化学吸附自限制过程不同,顺次反应自限制原子层沉积过程是通过活性前驱体物质与活性基体材料表面化学反应来驱动的。这样得到的沉积薄膜是由于前驱体与基体材料间的化学反应形成的。图a和b分别给出了这两种自限制反应过程的示意图。由图可知,化学吸附自限制过程的是由吸附前驱体1(ML2)与前驱体2(AN2)直接反应生成MA原子层(薄膜构成),主要反应可以以方程式⑴表示。对于顺次反应自限制过程首先是活化剂(AN)活化基体材料表面;然后注入的前驱体1(ML2)在活化的基体材料表面反应形成吸附中间体(AML),这可以用反应方程式⑵表示。反应⑵随着活化剂AN的反应消耗而自动终止,具有自限制性。当沉积反应前驱体2(AN2)注入反应器后,就会与上述的吸附中间体反应并生成沉积原子层。
图 A.化学吸附(CS)和B.顺次反应(RS)自限制原子层沉积过程示意图
ML2 + AN2 --- MA(film) + 2LN ⑴
AN + ML2 --- AML + NL ⑵
AML + AN2 --- MAN + NL ⑶
这里需要说明的是前躯体1能够在基体材料表面快速形成稳定的化学吸附层是化学吸附自限制原子沉积过程的必要条件。对于顺次反应自限制过程,一方面基体材料表面必须先经过表面活化,另一方面,这种沉积反应实际是半反应⑵和⑶的组合。每个半反应完成后材料表面的功能基团都会发生变化,并且一个原子层沉积完成时,材料表面要恢复到最初的活化基团状态。这种恢复特点以及材料表面原始活性状态是区分上述两种不同的自限制反应沉积过程的主要因素。
技术应用:
原子层沉积技术由于其沉积参数的高度可控型(厚度,成份和结构),优异的沉积均匀性和一致性使得其在微纳电子和纳米材料等领域具有广泛的应用潜力。就已发表的相关论文和报告可预知,该技术可能应用的主要领域包括:
1) 晶体管栅极介电层(high-k)和金属栅电极(metal gate)
2) 微电子机械系统(MEMS)
3) 光电子材料和器件
4) 集成电路互连线扩散阻挡层
5) 平板显示器(有机光发射二极管材料,OLED)
6) 互连线势垒层
7) 互连线铜电镀沉积籽晶层(Seed layer)
8) DRAM、MRAM介电层
9) 嵌入式电容
10) 电磁记录磁头
11) 各类薄膜(<100nm)
原子层沉积技术沉积出的相关薄膜材料
材料类别 沉积材料
Ⅱ-Ⅵ化合物 ZnS,ZnSe,ZnTe,ZnS1-xSex,CaS,SrS,BaS,SrS1-xSex,CdS,CdTe,MnTe,HgTe,Hg1-xCdxTe,Cd1-xMnxTeⅡ-Ⅵ基TFEL磷光材料 ZnS:M (M=Mn,Tb,Tm),CaS:M (M=Eu,Ce,Tb,Pb),SrS:M (M=Ce,Tb,Pb,Mn,Cu)
Ⅲ-V化合物 GaAs,AlAs,AlP,InP,GaP,InAs,AlxGa1-xAs,GaxIn1-xAs,GaxIn1-xP
氮(碳)化物 半导体/介电材料 AlN,GaN,InN,SiNx
导体 TiN(C),TaN(C),Ta3N5,NbN(C),MoN(C)
氧化物 介电层 Al2O3,TiO2,ZrO2,HfO2,Ta2O5,Nb2O5,Y2O3,MgO,CeO2,SiO2,La2O3,SrTiO3,BaTiO3
透明导体/半导体 In2O3,In2O3:Sn,In2O3:F,In2O3:Zr,SnO2,SnO2:Sb,ZnO,ZnO:Al,Ga2O3,NiO,CoOx
超导材料 YB2Cu3O7-x
其他三元材料 LaCoO3,LaNiO3
氟化物 CaF,SrF,ZnF
单质材料 Si,Ge,Cu,Mo,Pt,W,Co,Fe,Ni,Ru
其他 La2S3,PbS,In2S3,CuGaS2,SiC
应用案例:晶体管材料制备方面的应用
原子层沉积技术凭借其独特的表面化学生长原理、亚纳米膜厚的精确控制性以及适合复杂三维高深宽比表面沉积等特点,特别适合这类薄膜材料的制备。例如:S.F. Bent等人利用十八烷基磷酸盐(ODPA)对Cu的选择性吸附(图4),在预先吸附有ODPA分子的衬底表面进行ALD沉积Al2O3,有效避免了Al2O3在Cu表面沉积,从而得到被高k绝缘材料Al2O3所间隔的空间选择性暴露表面Cu的优质薄膜材料。此外,电镜照片(图5)表明该沉积方法的区域选择性得到了有效保证。
图4. ALD区域选择性沉积Al2O3原理
图5.(a)(d)(g)图案化的Cu/SiO2衬底SEM照片;(b)(e)(h)ODPA处理1 h经Al2O3ALD沉积后的Cu/SiO2衬底Al俄歇图像;(c)(f)(i)沉积完经醋酸溶液中超声10 min处理后的Cu/SiO2衬底Al俄歇图像。
原子层沉积的优势:
从原理上说,ALD是通过化学反应得到生成物,但在沉积反应原理、沉积反应条件的要求和沉积层的质量上都与传统的CVD不同,在传统CVD工艺过程中,化学蒸汽不断通入真空室内,因此该沉积过程是连续的,沉积薄膜的厚度和温度、压力、气体流量以及流动的均匀性、时间等多种因素有关;在ALD工艺过程中,则是将不同的反应前驱物以气体脉冲的形式交替送入反应室中,因此并非一个连续的工艺过程。相对于传统的沉积工艺而言,ALD在膜层的均匀性、阶梯覆盖率以及厚度控制等方面都具有明显的优势。
在某些应用中,需要在具有很大长径比的内腔表面镀膜,极限的情况下长径比会达到15甚至20,采用传统的镀膜方法是无法实现的,而原子层沉积技术由于是通过在基底表面形成吸附层,进一步通过反应生成薄膜,因而在这方面具有独特的优势,可以在大长径比的内腔表面形成厚度均匀的薄膜。
图6.原子层沉积技术与其他制膜技术对比
图7
原子层沉积技术的发展:等离子体增强原子层沉积(Plasma-Enhanced AtomicLayer Deposition,PEALD)
原子层沉积技术经过四十多年的发展,无论是在沉积材料的种类还是具体沉积方法的扩展与改进上,都已经取得了长足进步,在众多领域更是展现出令人期待的商业前景。但传统的热原子层沉积技术在发展过程中仍面临着一些挑战。比如:原子层沉积前驱体往往都是金属有机化合物,合适的前驱体种类较少而且价格昂贵;传统热原子层沉积技术因需要长时间的惰气吹扫以保证随后的表面自限制薄膜生长,沉积速率较慢,不适合大规模工业生产;此外,热原子层沉积技术难以用来沉积金属Ti,Ta等特殊材料。
随着原子层沉积技术与其他先进技术不断融合以及人们对原子层沉积设备的不断改进,诸如“等离子体增强原子层沉积技术”、“空间式原子层沉积技术”、“流化床原子层沉积技术”等新型原子层沉积技术逐渐出现并在一定程度上有效解决了传统热原子层沉积技术所面临的诸多难题。下面主要介绍等离子体增强原子层沉积技术(PEALD)
1991年,荷兰科学家deKeijser和van Opdorp首次使用氢气等离子体与三甲基镓和砷化氢反应外延生长砷化镓,进而提出了等离子体增强原子层沉积技术。
在过去二十多年,等离子体增强原子层沉积技术发展迅速。通过巧妙设计等离子体引入方式,人们已经设计出如图8所示各种等离子体增强原子层沉积设备。
图8.(A)直接等离子体增强原子层沉积;(B)远程等离子体增强原子层沉积;(C)自由基增强原子层沉积。
图9.(A)等离子体增强原子层沉积与热原子层沉积原理图对比;(B)不同衬底和沉积材料对应的沉积温度范围;(C)利用不同原子层沉积技术在Si (111) 表面生长AlN时,初始阶段膜厚随ALD循环次数变化(插图为沟道结构Si衬底表面采用N2-H2 PEALD技术沉积AlN SEM截面图)。
如图9A,与热ALD相似,PEALD的每一循环也由前驱体A脉冲吸附、惰气吹扫、前驱体B脉冲吸附、惰气吹扫四步组成,但与热ALD不同之处在于,PEALD采用了含有各种高活性粒子(如:含有O2、O、O2*、O*、O2+、O+、O-等活性物种的O2等离子体)的等离子体B*来代替前驱体B与吸附于衬底表面的前驱体A反应。高活性物种的引入不仅在很大程度上提高了原子层沉积的速率,而且还避免了热ALD中的延迟成核现象的发生(图9C),从而改善了薄膜质量。此外,采用PEALD还可以拓宽前驱体种类和ALD温度窗口(图9B),使得生物材料和聚合物材料等温度敏感型衬底表面的沉积以及需要高温活化的前驱体物质的沉积成为可能,从而使原子层沉积技术能应用于更多的领域。
以聚合物表面沉积贵金属Ru为例(图10),使用RuO4为前驱体与H2进行热ALD沉积金属Ru薄膜时,RuO4在100度以上即发生热分解,引发类CVD生长,不利于膜厚控制和三维共形生长。当沉积温度降至50度时,测量发现,薄膜生长缓慢。75度薄膜生长明显,但XPS测试显示所得金属Ru薄膜中含有大量O,这与低温下H2活性不足密切相关,从而极大降低了薄膜的导电性能。因此,传统热ALD用于沉积金属Ru只在100度附近存在一个较窄的沉积窗口。当使用等离子体H2代替普通H2后,在50至100度范围均能进行Ru薄膜的快速生长,XPS测试也显示薄膜含氧量较低。由此可以看出等离子体技术的引入可以在一定程度上解决目前热原子层沉积所面临的困难。
目前,等离子体增强原子层沉积不仅能够在更温和条件下沉积传统热原子层沉积能够沉积的一些金属以及氧化物等薄膜材料,还可以沉积通常采用CVD在高温条件下才能沉积的石墨烯等新兴材料。
图10. 采用ALD、PEALD生长金属Ru的特点
- 2023-08-09 15:13:49原子层沉积ALD在纳米材料方面的应用
在微纳集成器件进一步微型化和集成化的发展趋势下,现有器件特征尺寸已缩小至深亚微米和纳米量级,以突破常规尺寸的极限实现超微型化和高功能密度化,成为近些年来的热点研究领域。微纳结构器件不仅对功能薄膜本身的厚度和质量要求严格,而且对功能薄膜/基底之间的界面质量也十分敏感,尤其是随着复杂高深宽比和多孔纳米结构在微纳器件中的应用,传统的薄膜制备工艺越来越难以满足其发展需求。ALD 技术沉积参数高度可控,可在各种尺寸的复杂三维微纳结构基底上,实现原子级精度的薄膜形成和生长,可制备出高均匀性、高精度、高保形的纳米级薄膜。
微机电系统(MEMS)是尺寸在几毫米乃至更小的高科技装置,其内部结构一般在微米甚至纳米量级,是一个独立的智能系统,主要由传感器、动作器(执行器)和微能源三大部分组成,广泛应用于智能系统、消费电子、可穿戴设备、智能家居、系统生物技术的合成生物学与微流控技术等领域。MEMS的构造过程需要精细的微纳加工技术,而工作过程伴随着器件复杂的三维运动,其中ALD技术均可发挥重要作用,ALD具有高致密性以及高纵宽比结构均匀性,为MEMS机械耐磨损层、抗腐蚀层、介电层、憎水涂层、生物相容性涂层、刻蚀掩膜层等提供优质解决方案。
磁隧道结(MTJ)是由钉扎层、绝缘介质层和自由由层的多层堆垛组成。在电场作用下,电子会隧穿绝缘层势垒而垂直穿过器件,电子隧穿的程度依赖于钉扎层和自由层的相对磁化方向。随着MTJ尺寸的不断缩小以及芯片集成度的不断提高,MTJ制备过程中的薄膜生长工艺偏差和刻蚀工艺偏差的存在,将会导致MTJ状态切换变得不稳定,并降低MTJ的读取甚至会严重影响NV-FA电路中写入功能和逻辑运算结果输出功能的正确性。ALD技术沉积参数高度可控,可通过精准控制循环数来控制MTJ所需达到的各项参数,是适用于MTJ制造的最佳工艺方案之一。
生物物理学微流体器件可由单个纳米孔和电极组成,也可以由许多纳米孔阵列组成,可同时筛选、引导、定位、测量不同尺度的生物大分子,在生物物理学和生物技术领域中有着广泛的应用前景。生物纳米孔逐渐受到了人们的普遍重视引起了人们的广泛兴趣,尤其是纳米孔作为生物聚合物的检测器件,为一些生物化学现象的基础研究提供了研究的平台。然而生物纳米孔所固有的一些缺陷也很明显,如生物相容性差及微孔的尺寸不可更改等;针对于此,ALD技术可通过表面修饰,改善纳米孔的生物相容性,同时提升抗菌抑菌和促进细胞合成。
图一: ALD Al2O3(仅~10 nm)可作为MEMS齿轮高硬度润滑膜
图二:ALD应用于低温MEMS器件构造
图三:MRAM磁隧道结(MTJ)存储元件
图四:一种具有纳米蛛网结构的细菌纤维素膜
- 2020-12-07 09:36:52原子层沉积技术——“自下而上”JZ构建和调控异质催化剂结构和性能
引言
异质催化剂的合成通常借助于传统的湿法化学法,包括浸渍法、离子交换和沉积-沉淀法等。然而,这些方法合成的催化材料往往具有非常复杂的结构和活性位点分布不均匀等问题,这些问题会显著降低催化剂的催化性能,特别是在选择性上,阻碍了科学家们在原子水平上理解催化剂的结构-活性关系。此外,在苛刻的反应条件下通过烧结或浸出造成的活性组分的损失会导致催化剂的大面积失活。因此,亟待发展一种简便的方法来调控催化剂的活性位结构和其在原子水平上的局部化学环境,从而促进对反应机理的理解和高稳定性催化剂的合理设计。
原子层沉积(ALD, Atomic layer deposition)是一种用于薄膜生长的气相催化剂合成技术,目前已成为一种异质催化剂合成的替代方法。和化学气相沉积(CVD, Chemical vapor deposition)一样,其原理是基于两种前驱体蒸汽交替进样,并在载体表面上发生分子层面上的“自限制”反应,实现目标材料在载体表面上的JZ沉积。通过改变沉积周期数、次序和种类等方法可以实现对催化剂活性位结构的原子级精细控制,进而为研究者提供了一种 “自下而上”JZ可控合成催化剂的新策略。
美国Arradiance公司的GEMStar系列台式原子层沉积系统(如图1所示),在小巧的机身(78 * 56 * 28 cm)中集成了原子层沉积所需的所有功能,可最多容纳9片8英寸基片同时沉积。全系配备热壁,结合前驱体瓶加热,管路加热,横向喷头等设计,使温度均匀性高达99.9%,气流对温度影响减少到0.03%以下。高温度稳定度的设计不仅可在8英寸基体上实现厚度均匀的膜沉积(其厚度均匀性高于99%),而且适合对具有超高长径比孔径的3D结构进行均匀薄膜覆盖,在高达1500:1长径比微纳深孔内部也可均匀沉积。
图1. 美国Arradiance公司生产的GEMStar系列台式三维原子层沉积系统
在本篇文章中,我们将介绍利用ALD方法在负载型单金属 和双金属催化剂精细设计方面的进展和ALD方法在设计GX催化剂方面的特点与优势。同时,我们也整理了利用ALD技术制备单原子和双原子结构金属催化剂的方法与策略以及利用氧化物可控沉积JZ调控金属催化活性ZX周围的微环境,从而实现提升催化剂活性、选择性和稳定性的方法。ZH我们也将展望ALD技术在催化剂制备领 域中应用的潜力。
ALDJZ合成负载型催化剂近年来,研究者对各种氧化物和碳基材料基底上的金属ALD催化剂进行了广泛研究。由于高温下ALD生长的金属原子在氧化物和碳基基底上的高迁移率,沉积物通常以金属纳米粒子形式存在,而不是二维金属薄膜。如图2a所示,金属纳米颗粒的尺寸大小和负载量可以通过调整ALD循环次数和沉积温度变化来进行精确调控,且金属颗粒的尺寸分布通常非常狭窄。近期,ZG科学技术大学的路军岭课题组使用ALD技术发展了一种双金属纳米粒子的合成新策略,即使用较低的沉积温度和合适的反应物,在负载的单金属纳米粒子表面增加第二金属组分,获得原子级可控的双金属纳米粒子(如图2b, PtPd双金属纳米粒子)。研究发现,在较低的温度下,金属基底会促进金属前驱体在其上的成核和ALD生长,而金属氧化物通常是惰性的,因此不能在低温下与金属前驱体反应和开始成核。
图2. ALD合成(a)单金属Pt纳米粒子,(b) 双金属PtPd纳米粒子,(c)Pt 单原子催化剂在N掺杂的石墨烯上,(d)Pd单原子催化剂在g-C3N4上,(e)二聚的Pt2/石墨烯催化剂。
原子分散的金属催化剂,由于其独特的催化性能和ZD的原子利用效率,越来越受人们的关注。使用ALD技术从气相中获得单原子催化剂具有很大的挑战性,因为ALD生长通常在高温下进行,金属的聚集会显著加剧,但考虑到ALD的自限特性,仍是有可能的。加拿大西安大略大学孙学良教授团队从事了先驱性的工作,在250℃下,对N掺杂的石墨烯表面进行五十次Pt ALD循环合成了Pt单原子催化剂(如图2c)。DFT计算表面,Pt单原子与N原子成键,其HER活性相对于商业Pt/C显著增强(~37倍)。类似的,路军岭团队通过调控石墨烯上的含氧官能团种类和数量,在150℃下对石墨烯表面进行一次Pd ALD循环(Pd(hfac)2-HCHO),合成了原子级分散的Pd单原子催化剂(如图2d),没有观察到Pd团簇和纳米粒子的形成。除此之外,使用ALD技术还可以合成原子级JZ的超细金属团簇,如二聚物等。如图2d所示,路军岭团队报道了Pt2二聚体可以通过ALD技术在石墨烯载体上创建适当的成核位点 “自下而上”制备获得,即Pt1单原子沉积,并在起始位点上进行Pt原子的选择性二次组装。
氧化物包覆实现金属催化剂的纳米尺度编辑
对于负载型金属催化剂来讲,其载体不仅仅是作为基底,也会通过电子转移或金属—氧化物相互作用,显著的调制金属纳米颗粒的电子性质。当氧化物层包覆在金属纳米颗粒上时,会形成新的金属-氧化物界面(如图3a),可以进一步改变金属纳米颗粒的电子性能和形貌,有望进一步提升其催化性能(如图3b)。金属纳米颗粒通常含有低配位位点(lcs)和高配位的台阶(HCSs),通过氧化物ALD沉积的选择性阻挡某些活性位点,局部改变其几何形态,影响催化过程中的化学键断裂和生成,导致不同的反应途径(如图3c)。另外,物理氧化包覆层还可以提高纳米颗粒的稳定性,在恶劣的反应条件下防止金属组分的烧结和浸出(如图3d)。在原子层面上精确控制氧化膜厚度,从而在高比表面材料上实现高的均匀性,使得ALD成为在纳米尺度上提高纳米金属催化剂催化性能的理想工具,且不会产生质量迁移的问题。
图3. (a)ALD氧化物包覆负载型纳米离子生成新的金属——氧化物界面ALD合成,(b)ZnO包覆Pt纳米粒子催化剂显著提高催化活性,(c)ALD氧化铝包覆Pd/Al2O3显著提高催化选择性,(d)TiO2包覆层显著提高Co@TiO2催化剂催化稳定性。
总结和展望
催化剂的原子级精确合成,是阐明催化作用的关键机制和设计先进高性能催化剂的关键。ALD独特的自限制特性可实现催化材料在高比表面材料上的均匀和可控沉积,实现一步步和“自底向上”的方式在原子层面上构建复杂结构的异质催化剂材料。这些ALD催化剂具有较高的均匀性,使其相对于传统方法制备的催化剂,拥有更好的或可观的催化性能,并可作为模型催化剂有助于阐明催化剂的结构-性能关系。
参考文献:
[1] Lu J. et.al, Acta Phys. -Chim. Sin. 2018, 34 (12), 1334–1357.
[2] F. H.; et al. J. Phys. Chem. C 2010, 114, 9758.
[3] Elam, J. W. Nat. Commun. 2014, 5, 3264.
[4] Liu, L. M.; et al. Nat. Commun. 2016, 7, 13638.
[5] You, R.; et al. Nano Res. 2017, 10, 1302.
[6] Huang, X. H.; et al. Nat. Commun. 2017,8, 1070.
[7] Elam, J. W. ACS Catal. 2016, 6, 3457.
[8] Lu, J. ACS Catal. 2015,5, 2735.
[9] Huber, G. W. Energy Environ. Sci. 2014, 7, 1657.
- 2018-12-07 18:43:57原子层沉积的原理
- 2018-11-25 15:27:34原子层沉积的应用












